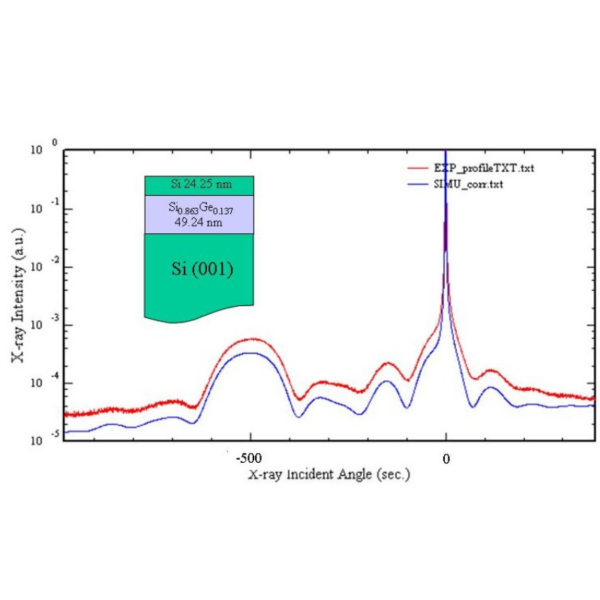
TEXTURA / ESTRÉS DE EPI-CAPAS
La difracción de rayos X de alta resolución se ha utilizado durante mucho tiempo en la industria de semiconductores compuestos para la caracterización de capas epitaxiales. Tradicionalmente se ha utilizado en la determinación del espesor y la composición de las epi-capas, pero más recientemente la técnica ha avanzado para permitir la determinación de la deformación y la relajación dentro de una capa determinada de una estructura multicapa. Se pueden utilizar curvas de oscilación de rayos X de alta resolución para analizar el espesor, la composición y el estado de deformación de las películas de monocristales epitaxiales. Gran parte de esta información se puede obtener simulando y / o ajustando la curva de oscilación medida utilizando la teoría de difracción dinámica de rayos X.
En la imagen (a la derecha), se analizó una película de SiGe que creció epitaxialmente sobre un sustrato de Si (001) junto con una capa superior de Si mediante epitaxia de haz molecular (MBE). El espesor nominal y la concentración de Ge de la capa de SiGe son 50 nm y 20,0%, respectivamente. El espesor nominal de la capa de recubrimiento es de 20 nm. La curva de oscilación experimental (roja) se midió en el difractómetro multipropósito SmartLab con un monocromador Ge (440) x4. La curva azul es el resultado del ajuste utilizando el software de análisis de curvas oscilantes de Rigaku. El ajuste está en excelente acuerdo con los datos medidos. A partir del ajuste, aprendemos que la capa de SiGe es en realidad 49,24 nm con una concentración de Ge del 13,7%. El espesor de la capa de cubierta de Si es de 24,25 nm, ligeramente superior al valor nominal. La curva azul es el resultado del ajuste utilizando el software de análisis de curvas oscilantes de Rigaku. El ajuste está en excelente acuerdo con los datos medidos. A partir del ajuste, aprendemos que la capa de SiGe es en realidad 49,24 nm con una concentración de Ge del 13,7%. El espesor de la capa de cubierta de Si es de 24,25 nm, ligeramente superior al valor nominal. La curva azul es el resultado del ajuste utilizando el software de análisis de curvas oscilantes de Rigaku. El ajuste está en excelente acuerdo con los datos medidos. A partir del ajuste, aprendemos que la capa de SiGe es en realidad 49,24 nm con una concentración de Ge del 13,7%. El espesor de la capa de cubierta de Si es de 24,25 nm, ligeramente superior al valor nominal.
NOTAS DE APLICACIÓN
Las siguientes notas de aplicación son relevantes para esta técnica.

